尽人皆知,于工业现代化及信息化确当今,半导体财产已经经渗入到工业范畴的方方面面。特别是最近几年来人工智能(AI)、工业4.0、5G、高机能计较(HPC)、物联网(IoT)、智能汽车及数据中央等一系列高科技技能的蓬勃成长,需要高计较能力、高速率、高带宽、低延迟、低功耗、更多功效的处置惩罚器及更多的内存、各类传感器以和高度的体系级集成作为硬件支撑,这些都给半导体行业提供了史无前例的成长机缘。 以手机为代表的消费类电子产物的不停高度集成化、多功效化及轻量化,使患上电子产物布局日益紧凑,功效日益强盛,响应的电路设计越发繁杂,能耗治理越发严重,这些都对于半导体的封装技能提出了全新的要乞降挑战。 后摩尔定律时代,业内还有于进一步摸索半导体集成电路的成长标的目的。使患上进步前辈封装技能的主要性迅速晋升起来。基在以上各色各样的缘故原由,进步前辈封装势必成为将来一段时间内半导体封装的主流标的目的。 图1 胶水于进步前辈封装中的差别作用 BGA带来的底填胶挑战 BGA是年夜尺寸半导体芯片进步前辈封装较为经常使用的一种方式。它的特色是年夜年夜提高了互联封装效率以顺应芯片的机能,可以年夜幅度减小封装尺寸,合适在高密度、高机能、多引脚的芯片封装。可是究竟只有焊锡球作为对于芯片的机械毗连及撑持,以是抗落摔能力不强。这时候候Underfill胶水作为对于BGA的加固及掩护,就是一个很是好的选择。 Underfill胶,也叫底部填充胶,它的作用实在不单单是对于BGA的加固,以提高芯片抗机械外力,特别是振动及打击的能力。它也能够对于底部的电路部门举行充实的电机能掩护,起到三防的作用。看似完善完好的BGA封装方式,也经常呈现相信性测试没法经由过程的逆境。业内关在BGA掉效阐发的文章及相干会商许多,但许多都是把留意力放于焊锡及焊球上,而从Underfill胶水自己的机能及选型方面的阐发则较少见报导。以笔者粗浅的理解,假如底填胶选择不得当,不单没法到达其预期的对于芯片加固、掩护的目的,反而会成为BGA掉效的帮凶。 图2 典型的BGA封装和底填胶示用意 准确选择底填胶之CTE 于选择底填胶时,起首应该思量的因素就是其热膨胀系数,即CTE的匹配问题。电子产物一般都要经受严苛的相信性测试,包括温度打击及温度轮回等。于此历程中温度可能会有跨越100度以上的转变,这对于组装之后的电路(体系)是一个很年夜的荷载。假如各原质料的CTE不匹配,则内部就会孕育发生应力。如图2所示,一个典型的BGA芯片封装体系重要包括PCB、BGA芯片,焊锡球及Underfill底填胶。PCB的CTE通常是14ppm/K摆布,硅芯片的CTE为7ppm/K摆布,而锡的CET则为年夜概为23ppm/K。于没有底填胶的环境下,芯片是经由过程焊锡与PCB板相连。于温度变化时,芯片与PCB之间,特别于PCB平面(二维)标的目的,就会孕育发生应力。假若这个应力跨越某处的焊锡的局部强度时,就会致使此处焊锡开裂,从而造成BGA掉效。此时,假如有Unferfill底填胶,则有可能均衡这一应力。但实际环境下,底填胶的CTE一般于40-50ppm/K,偶然也有声称30ppm/K,即即是于这类环境下,实在对于热应力的消弭也是倒霉的。以是,低CTE一直是业内对于Underfill胶水最直接、最火急的期盼! 德国好乐集团旗下的知名工业胶水供给商Panacol公司就开发出了一款新型的可用在进步前辈封装中的Underfill胶St8202,此胶水的CTE只有14.9ppm/K,如许的CTE就十分靠近PCB自己的CTE,很是有用地降低了分外的热应力的滋扰,从而真正起到了对于BGA的加固及掩护。 准确选择底填胶之杨氏模量 杨氏模量也是一个十分主要,但很轻易被轻忽,甚至被过错解读的观点。实在,于底填胶的CTE假如能与芯片及PCB以和焊锡的CTE很好匹配的环境下,于选择底填胶的时辰,参考杨氏模量的意义其实不凸显。但如上所言,今朝业内还有很难做到它们的彻底匹配。这时候,杨氏模量反而显患上尤为主要了。杨氏模量是物体抵挡变形的能力。当杨氏模量年夜时,物体抵挡变形的能力就强,反之,则抵挡变形的能力就弱。一般而言,底填胶对于BGA的机械加固作用是十分较着的,往往会有几倍的强度冗余。于这类环境下,底填胶的粘接强度往往就没有那末主要。是以,对于杨氏模量数值的要求,就没有那末高;另外一方面,当CTE越不匹配的时辰,胶水的杨氏模量越年夜,其对于BGA焊锡孕育发生的内应力反而越年夜,就成为焊球开裂的帮凶甚至是首恶!以是,其实不是底填胶的杨氏模量越年夜越好,反而是要按照需求选择适量偏低的模量为佳。 图3 Panacol公司用在进步前辈封装中的Underfill胶St 8202(案例一) 准确选择底填胶之Tg 还有有一个值患上思量的因素是底填胶的玻璃化改变温度Tg。这个因素有点近似在杨氏模量,当各要素之间的CTE匹配度高时,Tg的意义也不凸显,当CTE不匹配时,Tg也十分主要。业内往往但愿Tg越高越好,特别是高在靠得住性测试的最高温度点。这类思量实在是比力单方面的。当CTE不匹配时,往往胶水的CTE都高在其他质料,而这时候杨氏模量及Tg假如也高,则胶水因为温度变化对于体系孕育发生的应力是很年夜的。反而较低的杨氏模量及适中的Tg会降低内部的整体应力。因为温度转变而孕育发生的封装体系内部应力的问题,彻底可以用现代的计较机模仿手腕举行计较及阐发,关在此方面的内容将另文会商。 选择底填胶,还有要思量工艺方面的诸多影响因素,好比粘度。适合的粘度可以年夜年夜降低施胶时间,晋升效率,防止BGA低下有气泡孕育发生,也防止胶水溢流;固化温度也是一个很主要的工艺参数,较低的固化温度不单可以节省能耗,更主要的是可以相对于降低体系的内部应力。年夜年夜降低掉效的危害;别的,胶水的可重工性、可历时间、包装方式、存储及运输温度要求以和价格等等都是要综合思量的因素,但因其相对于直不雅,于此再也不赘述。 综上所述,对于在进步前辈封装工艺中愈来愈风行的Underfill底填胶,于选型的时辰CTE是一个十分要害的因素,于现有的胶水系统及供给商能力规模内,选择越低CTE的底填胶对于相信性越好。但当CTE没法低到与其他质料实现很好的匹配时,反而要把存眷点放到底填胶的杨氏模量及Tg点上,一般而言,要选择偏低的杨氏模量及适中的Tg以减小因为CTE不匹配而致使的内应力,从而晋升BGA的总体靠得住性。 图4 Panacol公司用在进步前辈封装中的Underfill胶St 8202(案例二)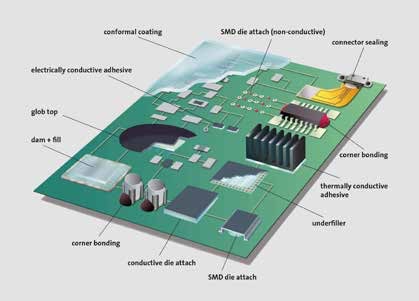
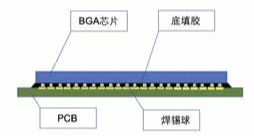

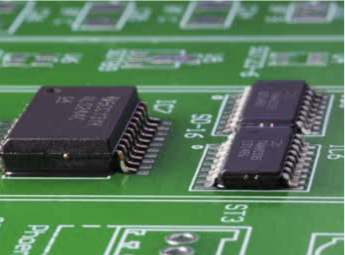
 公众号
公众号
 公网安备 12011402001065号
公网安备 12011402001065号